米樂M6:受困于良率?三星否認HBM芯片生產采用MR-MUF工藝
作者:米樂發布時間:2025-02-17
電子發燒友網報道(文/黃晶晶)據報道,三星電子在半導體制造領域再次邁出重要步伐,計劃增加“MUF”芯片制造技術,用于生產HBM(高帶寬內存)芯片米樂M6。但是三星在隨后的聲明中稱,關于三星將在其HBM芯片生產中應用MR-MUF(批量回流模制底部填充)技術的傳言并不屬實。三星在HBM生產中目前主要采用非導電薄膜(NCF)技術,而非SK海力士使用的批量回流模制底部填充(MR-MUF)封裝工藝。報道稱之所以要采用MR-MUF是為了解決NCF工藝的一些生產問題。幾位分析師也表示,三星的 HBM3 芯片生產良率約為 10-20%,而 SK 海力士的 HBM3 生產良率約為 60-70%。NCF技術(非導電薄膜技術),是使用熱壓縮薄膜來連接芯片。可以減少堆疊芯片之間的空間,從而在緊湊的HBM芯片組中堆疊多層芯片。MR-MUF則是將半導體芯片堆疊后,為了保護芯片和芯片之間的電路,在其空間中注入液體形態的保護材料,并進行固化的封裝工藝技術。與每堆疊一個芯片時鋪上薄膜型材料的方式相較,工藝效率更高,散熱方面也更加有效。這種技術為半導體制造帶來了更高的集成度和性能提升,尤其在處理大數據和復雜計算任務時,能夠顯著提升芯片的運行效率和穩定性。盡管在封裝上各自路徑不同,不過三星加快了HBM的研發步伐。目前三星已經發布最新的HBM3E 12H產品,將HBM3E DRAM芯片堆疊至12層,是迄今為止容量最大(36GB)的HBM產品。HBM3E 12H提供了高達每秒1280千兆字節(GB/s)的最高帶寬。三星HBM3E 12H采用了先進的熱壓非導電薄膜(TC NCF)技術,使得12層和8層堆疊產品的高度保持一致。三星電子稱,已經開始向客戶提供該芯片的樣品,并計劃在2024年上半年批量生產HBM3E 12H產品。美光科技也于日前宣布,已開始量產HBM3E,其24GB 8H HBM3E產品將供貨給英偉達,并將應用于NVIDIA H200 Tensor Core GPU,該GPU將于2024年第二季度開始發貨。美光HBM3E可提供超過1.2 TB/s內存帶寬,與競爭產品相比功耗降低約30%。根據產品規劃,美光還將推出超大容量36GB 12-Hi HBM3E堆疊。另有消息稱SK海力士今年3月量產全球首款HBM3E存儲器。從進度上來看,三星的HBM3E的量產時間略晚于SK海力士和美光科技。但是今年HBM三大家的競爭已經全面轉向HBM3E。那么產能也將是一個重要部署。三星電子此前表示,今年將把HBM供應能力保持在行業最高水平,將產能提升至去年的2.5倍,以滿足對人工智能芯片不斷增長的需求。SK海力士也同樣做好了提升HBM產能的準備。SK海力士2024 年計劃投資超過 10 億美元,擴大在韓國的測試和封裝能力。SK海力士負責封裝開發的李康旭副社長(Lee Kang-Wook)表示,SK海力士正在將大部分新投資投入到推進MR-MUF和TSV(硅通孔)技術中。
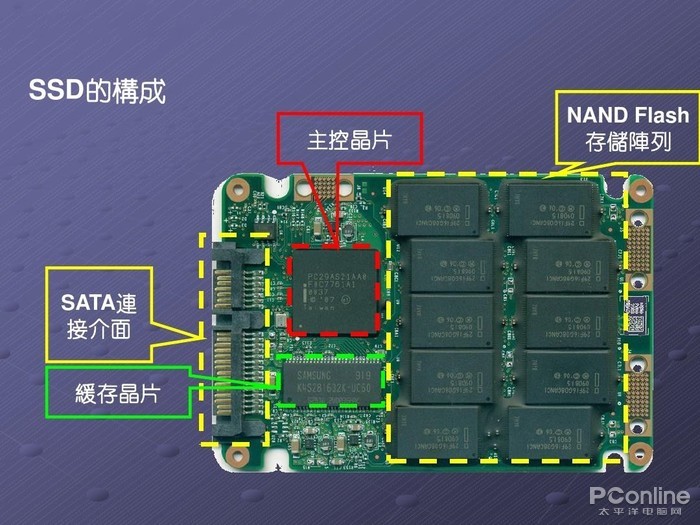
聲明:本文由電子發燒友原創,轉載請注明以上來源。如需入群交流,請添加微信elecfans999,投稿爆料采訪需求,請發郵箱huangjingjing@elecfans.com。
更多熱點文章閱讀
下手阻礙中國汽車?中美電動汽車產業發展走上不同路徑
三星蘋果入場!智能戒指市場不缺新玩家,專利提前站位
扁線電機加速滲透,或將主導新能源汽車市場米樂m6官網登錄入口
6G與AI強綁定,AI-RAN聯盟成立,無中國廠商參與?
蘋果十年造車終成空,轉向all in AI
點擊關注 星標我們
將我們設為星標,不錯過每一次更新!
喜歡就獎勵一個“在看”吧!



